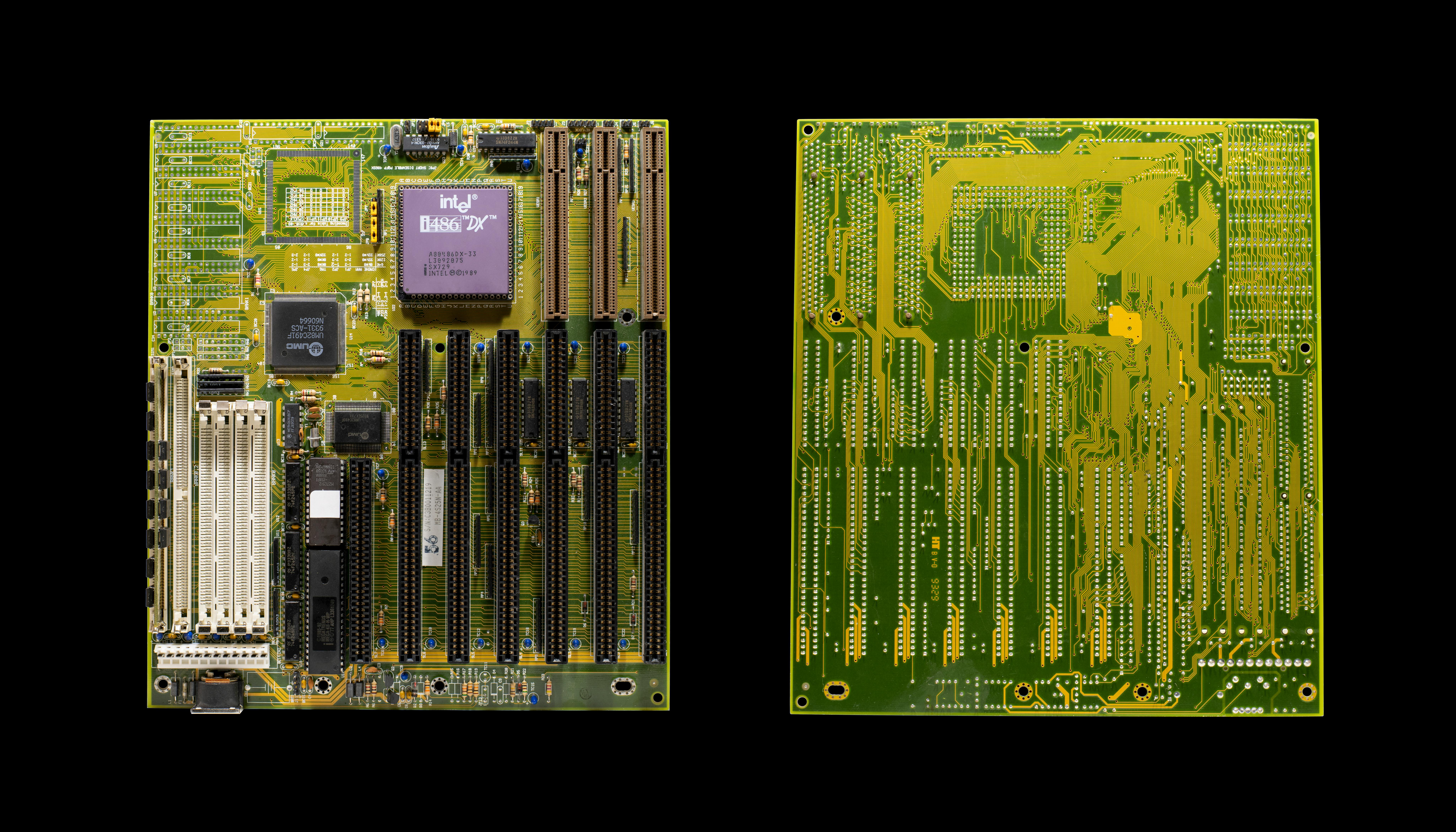
Intel EMIB與Foveros Direct:先進封裝技術能否力挽狂瀾,重塑競爭優勢?
隨著晶片設計日趨複雜,成本不斷攀升,Intel正積極擁抱模組化設計與先進封裝技術,期望透過EMIB和Foveros Direct等技術,將不同製程的模塊整合為單一晶片,進而提升產品的競爭力。本文將深入探討這些技術的特點、優勢以及可能面臨的挑戰,剖析Intel的未來發展策略。
Intel先進封裝技術:EMIB與Foveros Direct
- 什麼是EMIB?它如何提升效能?
EMIB(Embedded Multi-die Interconnect Bridge)是一種高效能運算設計的先進封裝技術,它可以在單一基板上連接多個晶片、記憶體以及I/O元件。EMIB的優勢在於低成本、高效能,特別適合用於資料中心複合晶片等應用。EMIB 3.5D更進一步,不僅能連接同層晶片,還能連接堆疊多層的晶片,提供更高的設計彈性及更小的外形尺寸。 - Foveros Direct的獨特之處是什麼?它為何能降低功耗?
Foveros Direct 3D則更為先進,完全採用混合鍵合技術,達成微米級點距、超高頻寬及低功耗互連等特色。相較於EMIB,Foveros Direct 3D將點距縮小至9微米,並以銅線直接連接,大幅降低資料傳輸的電力消耗,每位元大約只需0.05皮焦耳(pJ)的電力。
模組化設計的策略意義
模組化設計的核心理念是將晶片分解為多個獨立的模塊(Tile或Chiplet),這些模塊可以獨立設計、生產,然後透過先進封裝技術組裝成完整的晶片。這種設計方式帶來了多重優勢:
- 更高的可擴充性: 可以依照不同型號的需求配置數量各異的運算模塊,而無需針對每款型號重新設計。
- 延用既有模塊: 可以延用既有的模塊或小晶片,降低開發成本。
- 混合搭配不同製程: 可以在單一晶片中混合搭配多種不同製程,在負載大的運算模塊使用先進製程,在速度較慢的I/O模塊使用較成熟的製程,進而控制整體開發與生產成本。
Clearwater Forest處理器的實例分析
Intel的Clearwater Forest處理器是模組化設計的一個典型案例。它延用了前代處理器的I/O模塊,並使用了Intel 18A、Intel 3、Intel 7等三種不同的製程節點。Foveros Direct 3D負責連接運算模塊與基底模塊,而EMIB負責連接基底模塊與I/O模塊。基底模塊除了訊號傳輸功能外,還提供末端快取記憶體(LLC)功能。
先進封裝技術的優勢和潛在風險
先進封裝技術無疑是未來晶片發展的重要方向,但同時也存在一些潛在的風險:
- 優勢: 提高晶片效能、降低功耗、提升設計靈活性、降低生產成本。
- 風險: 技術複雜度高、生產良率挑戰、成本控制壓力、市場接受度。
Intel的未來動向:能否憑藉先進封裝技術突破重圍?
Intel將先進封裝列為AI時代的技術支柱,並將Intel 18A製程的RibbonFET與PowerVia技術,以及矽光子、擴展與堆疊列入其中。然而,先進封裝技術的成功不僅取決於技術本身,還取決於Intel的整體戰略、市場定位以及與其他廠商的合作。Intel能否憑藉先進封
相關連結:
Share this content:












