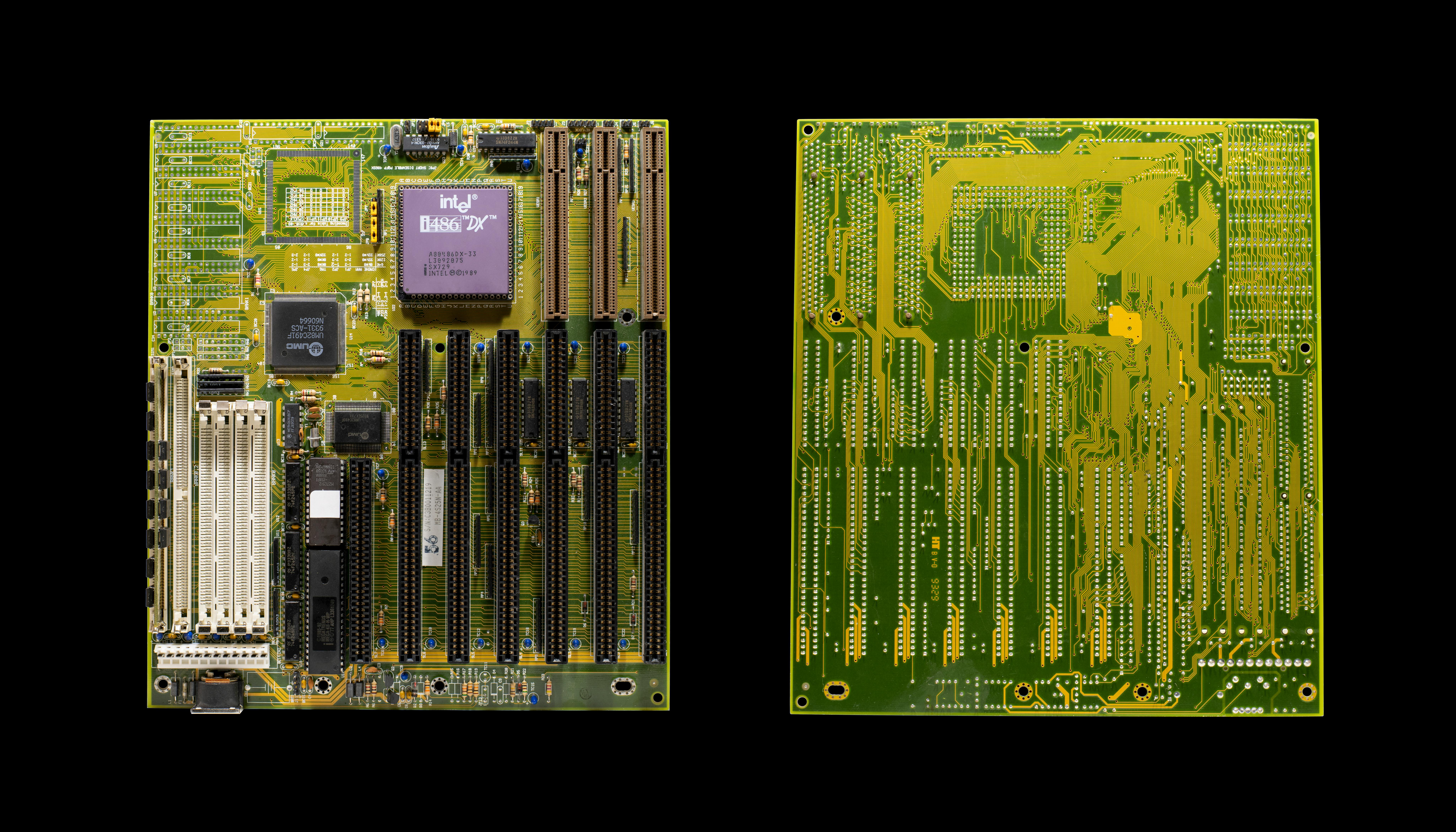
“`html
在晶片設計日益複雜、製程成本不斷攀升的今日,Intel正透過EMIB與Foveros Direct等先進封裝技術,積極擁抱模組化設計。這不僅能提升產品的靈活性與可擴展性,更能有效控制開發與生產成本,為其產品在市場上帶來強大的競爭力。本文將深入探討這些技術的原理、優勢,以及對未來晶片發展的影響。
Intel EMIB與Foveros Direct:模組化設計的核心
模組化設計猶如拼積木,將晶片分解為多個獨立的模塊(Tile或Chiplet),然後透過先進封裝技術將它們組裝在一起。這種設計方式具備極高的靈活性,可以根據不同產品的需求配置不同數量的運算模塊,無需為每個型號重新設計,大幅簡化了開發流程,並降低了成本。
多樣化的封裝技術:EMIB、Foveros與FCBGA
Intel擁有多種封裝技術,例如FCBGA、EMIB、Foveros等,每種技術都有其獨特的優勢與適用場景。
Clearwater Forest與Panther Lake:模組化設計的實例
Intel的Clearwater Forest與Panther Lake處理器正是模組化設計的實際應用。
模組化設計的優勢和隱憂分析
模組化設計帶來了許多優勢,但同時也存在一些挑戰。
- 提高可擴充性:可以根據不同需求配置不同數量的模塊。
- 降低開發成本:可以延用既有模塊或小晶片,減少重新設計的需求。
- 控制生產成本:可以在單一晶片中混合搭配多種不同製程,降低整體成本。
- 提高良率:晶片在封裝前會經過多次測試,篩選掉不良裸晶,提高整體良率。
相關連結:
Share this content:













